Verification and application of multi-source focus quantification
Résumé
The concept of the multi-source focus correlation method was presented in 2015 [1, 2]. A more accurate understanding of real on-product focus can be obtained by gathering information from different sectors: design, scanner short loop monitoring, scanner leveling, on-product focus and topography. This work will show that chip topography can be predicted from reticle density and perimeter density data, including experimental proof.Different pixel sizes are used to perform the correlation in-line with the minimum resolution, correlation length of CMP effects and the spot size of the scanner level sensor.Potential applications of the topography determination will be evaluated, includingoptimizing scanner leveling by ignoring non-critical parts of the field, and without the need for time-consuming offline topography measurements.
Fichier principal
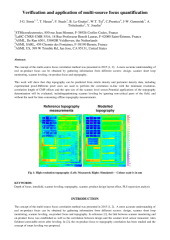 20160125_Verification_and_application_of_multi-source_focus_quantification.pdf (1.12 Mo)
Télécharger le fichier
20160125_Verification_and_application_of_multi-source_focus_quantification.pdf (1.12 Mo)
Télécharger le fichier
Origine : Fichiers produits par l'(les) auteur(s)
Loading...

